市場訊息
KRI 考夫曼聚焦射頻離子源 RFCIP220輔助濺射製備 GdF3光學薄膜
GdF3光學薄膜擁有優異的光學性能, 在深紫外光學薄膜中有廣泛應用, 以193nm投影光刻為例, 其系統有30~40個光學元件, 且部分元件口徑高達 400mm,為了使系統高品質成像, 不僅要求製備的薄膜具有極高的透過率和良好的抗鐳射損傷能力, 而且為了膜厚均勻性控制提出了極高的要求.
因此某光學薄膜製造商採用KRI 考夫曼射頻離子源 FRICP220 和射頻離子源 FRICP140輔助濺射製備GdF3光學薄膜, 以求獲得透過率高且良好抗鐳射損傷能力的均勻性的GdF3光學薄膜.
客戶離子束濺射系統裝置圖如下圖
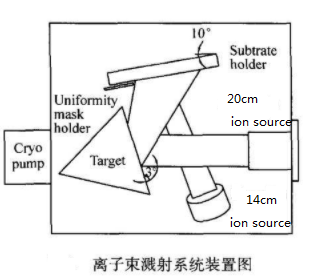
其中用於濺射的離子源為 20cm的 KRI 射頻離子源 RFICP220, 輔助離子源為12cm的KRI 射頻離子源 RFICP140.
.jpg)
伯東 KRI 射頻離子源 RFICP220 技術參數:
|
離子源型號 |
RFICP220 |
|
Discharge |
RFICP 射頻 |
|
離子束流 |
>800 mA |
|
離子動能 |
100-1200 V |
|
柵極直徑 |
20 cm Φ |
|
離子束 |
聚焦, 平行, 散射 |
|
流量 |
10-40 sccm |
|
通氣 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
|
典型壓力 |
< 0.5m Torr |
|
長度 |
30 cm |
|
直徑 |
41 cm |
|
中和器 |
LFN 2000 |
* 可選: 燈絲中和器; 可變長度的增量
.jpg)
伯東 KRI 射頻離子源 RFICP140 技術參數:
|
型號 |
RFICP 140 |
|
Discharge |
RFICP 射頻 |
|
離子束流 |
>600 mA |
|
離子動能 |
100-1200 V |
|
柵極直徑 |
14 cm Φ |
|
離子束 |
聚焦, 平行, 散射 |
|
流量 |
5-30 sccm |
|
通氣 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
|
典型壓力 |
< 0.5m Torr |
|
長度 |
24.6 cm |
|
直徑 |
24.6 cm |
|
中和器 |
LFN 2000 |
工藝簡介:
離子源工作氣體為Xe氣, NF3作為輔助氣體反應濺射, 靶材為金屬Gd靶.
KRI 射頻離子源 RFICP220 主要是用於產生高能Xe離子束轟擊靶材, 通過動量傳遞使靶材原子獲得足夠的動能而脫離靶材表面, 射向基板, 在基板的上沉積而形成一層薄膜; 另一個輔助離子源(KRI 射頻離子源 RFICP140)通入NF3, 通過對生長中的薄膜的轟擊, 使得薄膜進一步緻密, 同時改善薄膜的化學性能.
運行結果:
KRI 考夫曼射頻離子源輔助濺射製備GdF3光學薄膜具有極高的透過率和良好的抗鐳射損傷能力, 而且膜厚均勻性良好.
伯東是德國 Pfeiffer 真空泵, 測漏儀, 質譜儀, 真空計, 美國 KRI 考夫曼離子源, 美國 inTEST 高低溫衝擊測試機, 美國 Ambrell 感應加熱設備和日本 NS 離子蝕刻機等進口知名品牌的指定代理商.
.png)
若您需要進一步的瞭解詳細資訊或討論, 請參考以下聯絡方式:
上海伯東: 羅先生 臺灣伯東: 王小姐
T: +86-21-5046-1322 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 152-0195-1076 M: +886-939-653-958
ec@hakuto-vacuum.cn ec@hakuto.com.tw
www.hakuto-china.cn www.hakuto-vacuum.com.tw
伯東版權所有, 翻拷必究!
